產品應用與服務Product
DBG 製程特性
DBG製程與一般製程相較,可降低晶背chipping之發生,且在晶圓變薄前先完成刀切,因此在研磨製程中可解決 chipping問題。因晶背chipping減少,可增強晶片強度,經應力釋放製程後,可移除微裂痕而產生
更堅固的晶片。
DBG製程的優勢有...
- 晶片強度增強且無晶背chipping
- 提升小型晶片之生產力
- 適用於薄型晶圓加工且不會造成晶圓破損
DBG適用裝置
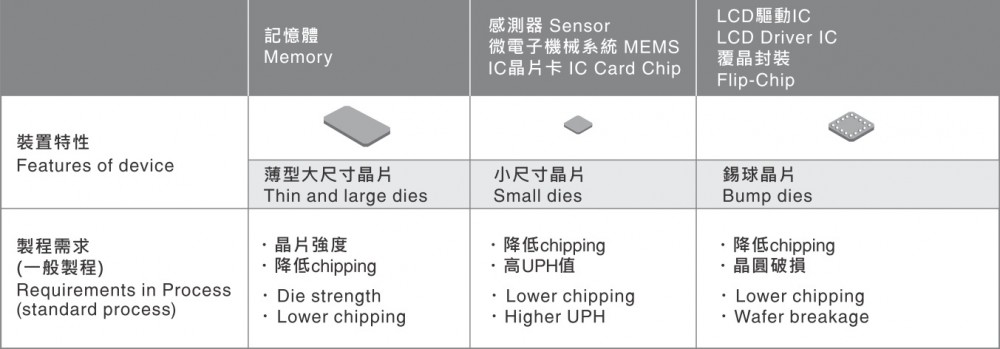
適用於DBG製程之研磨用保護膠帶
適用於DBG製程「研磨用保護膠帶 E-3000 series」。因具備晶圓電路面的高包覆性及紫外線照射後的低黏著力,可達到薄晶片的穩定加工性能。
對於研磨後厚度低於50µm的極薄晶片的製造,可達到優良的效果。
- 因具備高黏著力、高包覆性,可防止研磨時晶片的飛散及研磨水的浸入
- 降低晶背Chipping等問題發生
- 降低晶片位移(kerf shift)等問題發生
適用DBG製程之LD Tape黏晶切割膠帶
為結合DBG製程所需的黏晶切割膠帶。「黏晶切割膠帶 LD Tape」適用於Full Cut Laser Dicing,膠層可達到優良的分割效果。
- 降低Kerf Shrink、Kerf Shift,黏著劑層可進行Full Cut Laser Dicing
- 雷射切割後不需進行擴片製程即可分割(DAF)
- 具易撿晶功能,可有效達到高品質極薄晶片之製造生產
- 可提供黏著劑7µm厚度之產品