產品應用與服務Product
LE Tape 黏晶切割膠帶
各製程之膠帶用途
| 基板封裝用 款式:烘烤 |
黏接著劑厚度 10μm ~ 20μm |
|---|---|
| 薄型晶片封裝用 款式:烘烤 |
黏接著劑厚度 10μm ~ 25μm |
| 同尺寸晶片堆疊封裝用 款式:烘烤 |
黏接著劑厚度 75μm |

黏晶切割膠帶是結合切割膠帶與黏晶功能的高附加價值膠帶。取晶時黏著劑可直接轉移至晶圓背面,相較於一般的液態接著劑,不會有溢膠及晶片傾斜的問題發生,適用於薄型晶片堆疊封裝等的製程。此款膠帶可對應從切割到黏晶等製程,可實現製程簡化之目的。
1、切割時與一般切割膠帶相同,可確實固定晶圓,撿拾晶片時,膠帶上的黏著劑會移轉至晶片背面的多功能膠帶。
2、節省DAF貼合製程工序,可避免接著時熱處理造成對晶圓的損害,也可實現製程簡化的目的。
3、因為能利用低溫的熱硬化(晶圓貼合)/Heat Curing(Wafer Mounting)處理,可減輕因加熱對晶圓造成的損傷。
4、不會有溢膠及晶片傾斜的問題發生。
5、提供適用於薄型堆疊封裝用(Thin Stacked Packages)的「SDType」、基板凹凸面包覆性(Substrate Mounting)的「ESType」、同尺寸堆疊封裝用(Same-Size Stacked Packages)的「EWType」等3種類型膠帶,對於提升生產效率及封裝的薄型化具有貢獻。
LE Tape黏晶切割膠帶適用製程
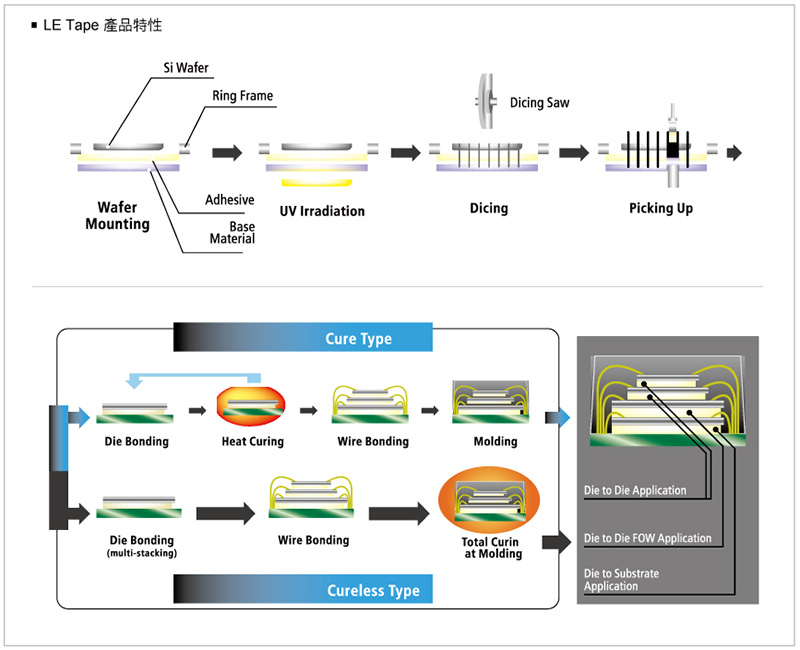
LE Tape黏晶切割膠帶與液態接著劑使用比較
| 比較項目 | LE Tape | 接著劑(銀膠) |
|---|---|---|
| 接著劑形態 | 均一、全面接著 | 不均一、部份接著 |
| 對晶片尺寸的影響 | 不受影響 | 有影響 |
| 接著劑及工具的控制 | 不需要 | 需要 |
| 硬化時接著劑的溢膠狀況 | 不會 | 會 |
基板貼合用「LE Tape ES Type」

- 針對基板等素材,有著高黏性的基板專用黏著劑。
- 黏晶後保持適度的彈性率,具實現良好的埋覆性能。
薄型晶片堆疊封裝「LE Tape SD Type」

- 接著劑厚度均一,可與同一尺寸晶片進行黏晶作業。
- 黏晶後保持適度的彈性率,具實現良好的埋覆性能。
同尺寸晶片堆疊封裝用「LE Tape EW Type」

- 金屬導線部分能確實埋覆於黏接著劑中,不會造成導線的損傷及碰觸到上層晶片底部等問題發生,實現具穩定性的同尺寸晶片堆疊作業。
- 晶片與晶片間不需Spacer,可達到薄型封裝及生產力提升的目的。
