最新消息News Center
開發有助於提升良率的樹脂塗佈製程
2026/03/02
降低半導體晶圓背面研磨工程的厚度偏差
針對半導體晶圓的背面研磨(Backgrinding)工程,琳得科(LINTEC)開發了「PCBL (Pattern Coating Before Lamination) 製程」,可有效改善晶圓正面因電路蝕刻段差所導致的厚度偏差。為了消除段差而開發的新型樹脂塗佈設備「RAD-3400F/12」,將於今年正式開始接受訂單。
降低晶圓厚度偏差的「PCBL 製程」
隨著半導體晶片微細化的發展,製程中將晶圓背面研磨至極薄且平坦的工程變得愈發重要。特別是抑制整片晶圓的厚度偏差、確保高度平坦性,更是提升晶片品質的關鍵。
然而,在正面(電路面)上形成有「錫球(Bump)」等突起電極的晶圓,其中央與邊緣常存在高低落差。在進行背面研磨前貼附保護表面的「研磨用保護膠帶(Back Grinding Tape)」時,晶圓邊緣會產生段差,這也成為研磨過程中產生裂紋(Crack,如缺角或裂縫)的原因。
因此,本公司開發了全新的 「PCBL 製程」。透過在沒有錫球的晶圓邊緣塗佈 UV 硬化型樹脂來消除段差,進而降低研磨後的厚度偏差及減少裂紋產生的風險。
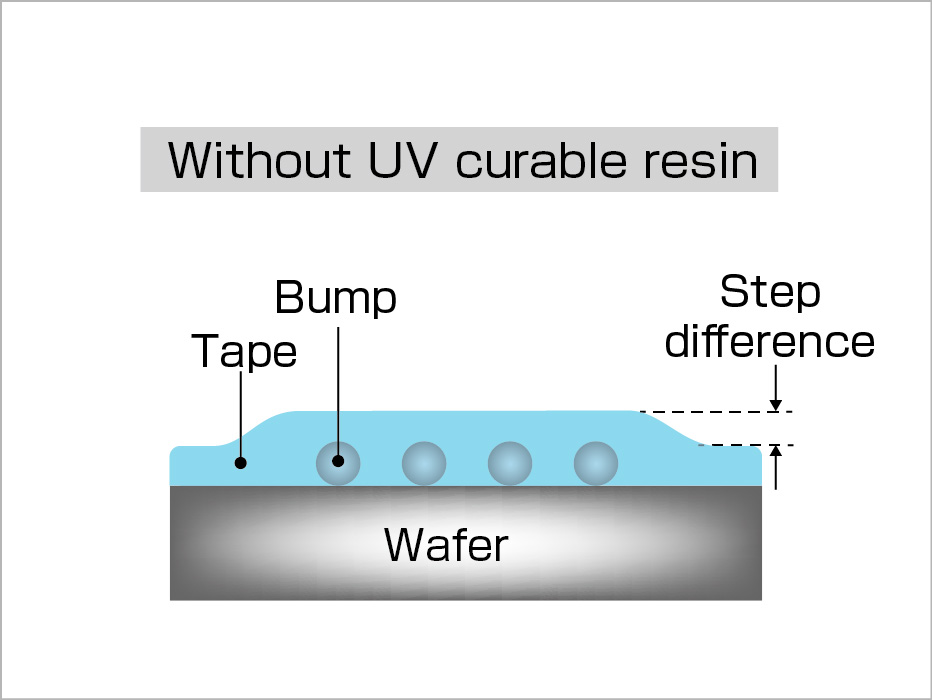

可依需求進行樹脂塗佈的新設備「RAD-3400F/12」
配合此製程,本公司同步開發了樹脂塗佈設備 「RAD-3400F/12」。該設備可調整塗佈樹脂的圖案、塗佈量、寬度與高度,根據錫球高度等晶圓規格進行客製化調整。此外,在塗佈樹脂後,可沿用現有的生產線貼附研磨用保護膠帶並進行背面研磨;研磨結束後將膠帶撕除時,樹脂也會隨著膠帶一同剝離。
本公司將加強推廣該設備與 PCBL 製程,致力於進一步提升半導體晶片製造的良率。
產品與製程概要及特點
- PCBL 製程:針對晶圓背面研磨工程,此製程旨在降低因晶圓中央與邊緣高低差所導致的厚度偏差與減少裂紋的發生。
- RAD-3400F/12 設備:適用於半導體晶圓上塗佈樹脂。在晶圓正面(電路面)較低的部分塗佈 UV 硬化樹脂,消除貼附背面研磨用保護膠帶時產生的段差。
- 高度客製化:可調整塗佈量與形狀以符合各種錫球規格。樹脂在研磨後可隨膠帶一併剝離。
- 線上化整合(In-line):該設備可與本公司的研磨用膠帶貼合機「RAD-3520F/12」串聯。無需變更現有生產線,即可導入此新製程。