產品應用與服務Product
RAD-2510F/12Sa (300mm全自動切割膠帶貼合機)

- 對應極薄晶圓製程
以180°剝除方式從晶圓上剝離研磨用保護膠帶,剝離膠帶時施於晶圓的壓力抑制到最小。 - 減少晶圓搬運次數
降低晶圓單體的搬運次數,在單機運轉時降至4次,以及與研磨機In-Line時降至2次,減少對晶圓的損傷。 - 高產能
優化各搬送機構,提高產能。
※相較於以往機型,可提升約60%產能。(為300mm裸晶運轉之比較值。實際產能,因貼合、剝離條件等有所差異。) - 省空間
設備尺寸:2,165mm(W) x 3,090mm(D) x 1,800mm(H)(不包含突起物及信號塔),為省空間的機台設備。
※相較於以往機型,節省約30%空間。 - 切割膠帶可在設備內進行預切割作業(此為選配項目)
使用非預切割膠帶切割時,為了增加鐵框使用壽命,使用獨特的機台內Precut機構,在設備內先進行膠帶預切割作業。此機構可依據客戶所需進行選配安裝。 - 撕研磨膠帶時,熱熔膠撕膠&一般黏著膠帶撕膠方式可兼用
因應使用的研磨膠帶物性,在撕研磨保護膠帶時可選擇間用熱溶膠撕膠方式及黏著膠帶方法。(黏著膠帶方式為選配項目) - 可對應DBG製程(此為選配項目)
於300mm/200mm晶圓貼合完切割膠帶後,再剝離表面保護膠,適用於極薄晶圓製程之次世代的產品製程。
選配項目
- 主機通訊(Host Communication)功能
(通訊方式:SECSI、HSMS 標準、軟體:GEM標準) - Vision System(晶圓ID Reader & 條碼貼合系統)
- 切割膠帶透過In-Line進行預切割作業
- 對應DBG製程
設備運作流程
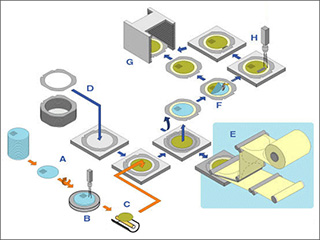
- 晶圓的裝載、掃描、取出
自動掃描晶舟盒內的晶圓收納狀態,由機械手臂取出反轉晶圓後,搬送到紫外線照射部。 - 晶圓定位
利用CCD相機方式,將晶圓以平邊或V型缺角定位後,吸盤台將晶圓搬運並放置於貼合作業台上。 - 紫外線照射
紫外線均一照射保護用研磨膠帶後,搬送到晶圓定位的工程。 - 鐵圈供給
從鐵框架箱中將重疊放置的鐵框架一片一片取出,並放置於貼合作業台上。 - 膠帶貼合
貼合作業台前後移動,以加壓滾輪將Precut Tape貼合在晶圓與鐵框架上。貼合時,利用TTC方式可得到膠帶貼合時最適切的張力。 - 剝離研磨用保護膠帶
保護用研磨膠帶從貼合完畢的晶圓上撕離。撕離後的膠帶,收集至機台內的集塵盒中。 - 晶圓收納
將貼合完畢的晶圓儲存至晶片盒(Frame Cassette)。 - 晶圓管理系統(選配項目)
讀取晶圓上的 ID 號碼,並將其資料轉為條碼化後貼上標籤,藉由本系統達到組裝工程的工廠自動化。