最新消息News Center
DBG製程滿足薄型晶片層疊需求
2021/02/08
電子設備不斷講求輕薄短小,因此內部晶片設計的「薄型化」及黏晶接著劑的「薄膜化」愈顯重要。為此,琳得科針對製造小於50μm的超極薄晶圓,搭配業界的DBG(Dicing Before Grinding)製程,提供符合製程需求的高品質DBG膠帶。
DBG製程採先切割後研磨的作法,適用於記憶體等薄型大尺寸晶片、感測器及IC晶片卡等小尺寸晶片,以及LCD驅動IC錫球晶片等,可提升小型晶片生產力,大幅降低晶背chipping並增加晶片強度,經壓力釋放製程後,可移除微裂痕產生更堅固的晶片。
適用於DBG製程之研磨用保護膠帶E-3000系列、黏晶切割膠帶LD Tape
琳得科研磨用保護膠帶E-3000系列適用於DBG製程,具晶圓電路面的高包覆性及紫外線照射後的低黏著力,可達到薄型晶片的穩定加工性能。E-3000系列分為薄型晶圓應用、錫球DBG製程及小尺寸晶片等三種款式。皆具高黏著力,可防止研磨時晶片飛散及研磨水浸入,並降低晶背chipping、晶片位移(kerf shift),以及晶圓研磨後翹曲等問題發生。
此外,琳得科亦提供適用於DBG製程的黏晶切割膠帶LD Tape,可降低Kerf Shrink及Kerf Shift,黏著劑層可進行Full Cut Laser Dicing,不須膠帶擴片製程即可進行DAF擴片,並具撿晶功能,可有效達到高品質極薄晶片生產製造。
紫外線硬化晶片背面保護膠帶大幅縮短熱固化時間
而在晶片背面保護膠帶部分,為解決傳統液態塗佈劑容易塗佈不均的問題,琳得科的LC Tape可實現產品厚度一致性,並具有良好的雷射打印特性,目前更開發出「紫外線硬化晶片背面保護膠帶」,以紫外線照射方式來取代現行的烤箱熱固化製程,製程時間由2小時大幅縮短為1至2分鐘,相較於過去以烤箱烘烤,待膠質硬化後再切割,紫外線硬化晶片背面保護膠帶大幅提升作業效率,且能在不施予晶圓壓力的狀況下剝離膠帶,亦適用於大尺寸及薄型晶圓等多種類型應用,建議搭配晶圓貼合機RAD-2510F/12Sa及紫外線照射機RAD-2010F/12以達到最佳製程效果。
若已設置紫外線照射機的客戶,將可直接應用此款膠帶,進一步節省成本及作業空間。紫外線熱固化技術引起許多客戶興趣,目前紫外線硬化晶片背面保護膠帶已進入測試及調整階段,相信不久的將來需求將大幅提升。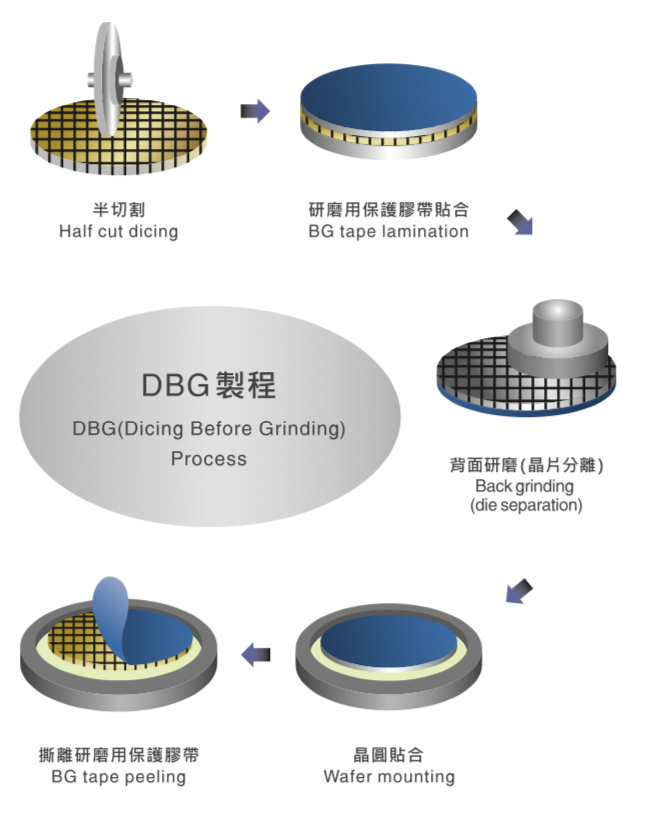
加快新產品開發腳步 同時提升既有產品品質
近年車用電子市場蓬勃發展,琳得科在加快新產品開發腳步的同時,也不斷精進自我,目前已著手籌備IATF 16949驗證相關程序文件與流程,由系統管理、教育訓練及實務作業三大面向上著手,以更嚴謹的標準,提供客戶更高品質的產品,並持續拓展產品應用範圍。
5G、AI、智慧運輸系統等,皆為近年半導體業界最熱門話題,預計將大幅改變人類日常生活。琳得科由自身做起,除了導入汽車品質管理系統之外,配合變化快速多端的市場需求,既有產品需保有更大的彈性及最佳的品質控管,同時也須加快新產品開發的速度,以求以最新技術迎合產業發展。琳得科與客戶一同前進,邁向科技新世代。